新聞中心
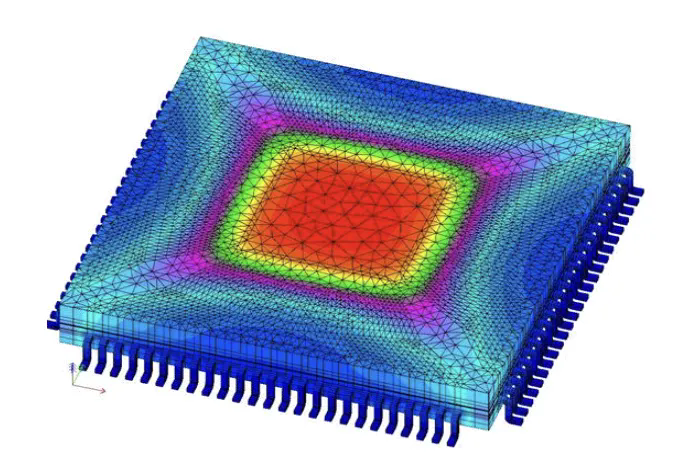

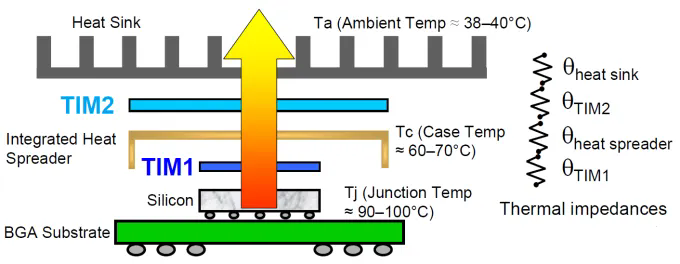
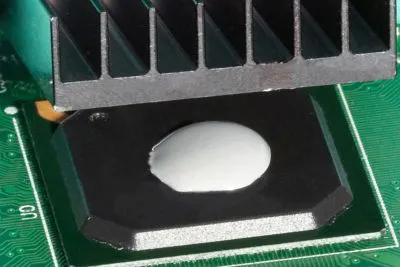
TIM2型材料用于封裝外部,位于散熱器和封裝之間。相較于TIM1,TIM2已遠離芯片,工作環境溫和,導熱性能要求相對較低,且無需電絕緣性。但它仍需有效傳導熱量,確保散熱。TIM2材料通常為碳基復合材料,且多為可分離設計,便于熱沉在系統級組裝過程中拆裝。
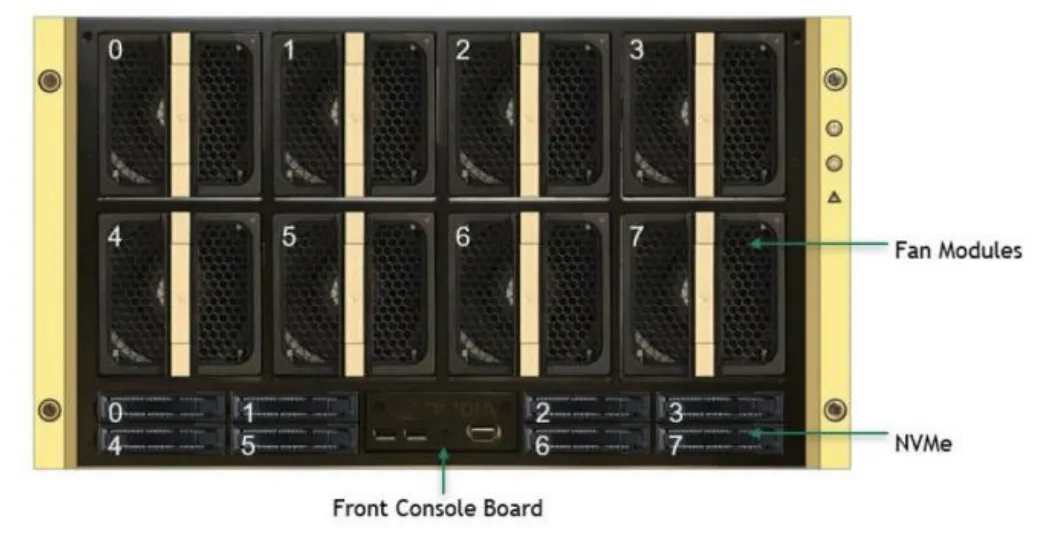
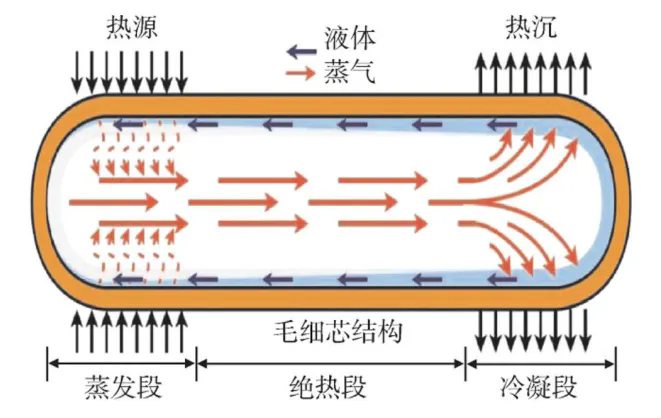
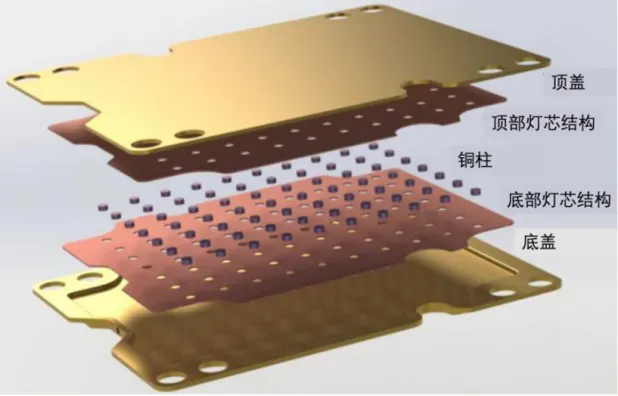
解決AI芯片散熱難題:導熱材料如何助力?
作者:vbond 發布時間:2024-10-14 14:21 瀏覽次數 :
隨著人工智能技術的飛速發展,AI芯片成為推動高性能計算的核心引擎。從訓練復雜的神經網絡到執行大規模的并行計算,AI芯片承擔著極高的運算負荷。然而,伴隨高計算密度而來的,是大量的熱量產生。若不能及時有效地散熱,不僅會導致芯片過熱,甚至可能影響到AI系統的整體性能與穩定性。因此,如何通過先進的導熱材料和散熱技術為AI芯片“降溫”,成為當前產業關注的焦點。
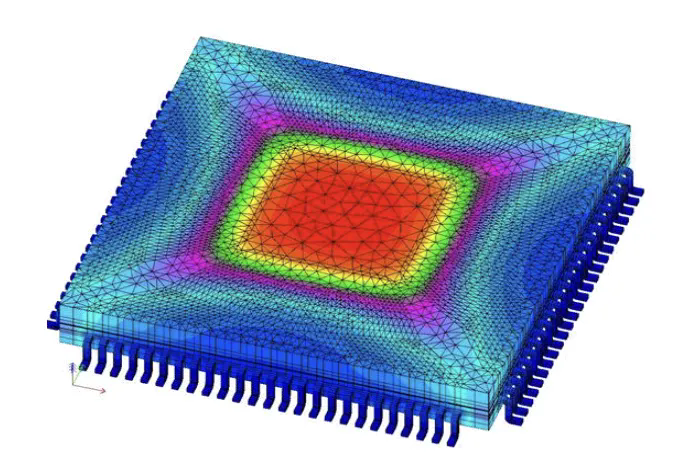
芯片的溫度云圖變化
一、AI芯片的散熱難題根源
散熱不良會對AI芯片性能和壽命的影響,如降低頻率、限流等。目前,AI芯片的散熱難題主要源于以下幾個關鍵原因:
01 高功率密度
AI芯片在執行復雜的計算任務時,需要極高的功率,這導致其單位面積內的功率密度大大高于傳統處理器。更高的功率密度意味著更多的熱量集中在更小的區域內,散熱難度增加。尤其是用于深度學習、推理和訓練模型的AI芯片(如GPU和TPU),其功耗和發熱量比普通CPU高得多。
比如說目前主流應用的NVIDIA A100 Tensor Core GPU就是專為AI和高性能計算設計,具有400W的最大功耗;專為高性能計算和AI推理任務設計AMD Instinct MI200加速卡,功耗接近500W。而今年,服務器制造商戴爾透露了NVIDIA即將推出的人工智能(AI)GPU,代號為Blackwell,功耗高達1000W,比上一代芯片的功耗足足增加了40%。面對這樣高的功率,必須要配套高效散熱解決方案。

02 芯片封裝設計的限制
隨著芯片集成度的提升,現代AI芯片包含了數十億個晶體管,尺寸越來越小,且設計上緊湊。這種高度集成的封裝設計導致芯片內部的熱量無法迅速有效地傳導至外部進行散熱。封裝材料的導熱性能有限,進一步加劇了熱量積累。
03 工作負載的連續性
AI芯片通常需要長時間持續工作,例如用于實時數據分析或訓練復雜的人工智能模型。這種連續性工作負載意味著芯片持續產生大量熱量,且散熱的時間窗口非常有限。傳統的散熱解決方案難以應對這樣長時間、高強度的工作負荷。
二、AI芯片散熱技術
散熱技術通過直接在芯片或處理器表面移除熱量來優化設備性能并延長使用壽命。隨著AI芯片的計算能力不斷提升,其功耗和熱量也隨之增加,傳統的散熱方案逐漸暴露出局限性。為了確保AI芯片能夠長時間高效運作,行業開始尋求更先進的散熱技術和材料創新。以下將分為散熱材料以及散熱技術兩部分總結。
散熱材料
01 熱界面材料(TIM)
在AI硬件中,由于器件制造公差和表面粗糙度的存在,器件之間通常會有微小的空隙。這些空隙含有空氣,而空氣是熱的不良導體,常溫下導熱系數僅為0.026W/(m·K)。因此,導熱界面材料(TIM)被用來填補這些空隙,排出空氣,提供更好的熱傳導路徑,降低界面熱阻,從而提升散熱效率。
以AI終端設備中的高功耗芯片為例,通常通過倒扣焊工藝實現散熱,芯片的熱量沿“芯片-TIM-封裝-TIM-散熱器”路徑傳導至外部。根據材料放置位置,TIM分為TIM1和TIM2兩種類型。
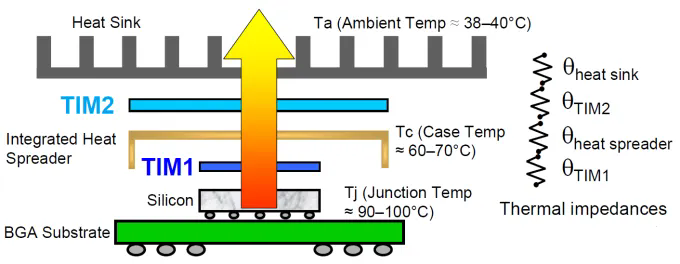
TIM1/ TIM2 結構(來源:硬件起源)
TIM1型材料用于芯片封裝內部,位于發熱芯片/管芯與散熱金屬蓋之間。TIM1直接接觸熱源,要求具備極高的導熱性能和電絕緣性,確保芯片有效散熱并避免短路。此外,由于芯片與金屬蓋的熱膨脹系數不同,TIM1還需具備合適的熱膨脹系數。主流TIM1材料通常由高導熱性粉體填充含硅或非硅聚合物制成,常見形態包括導熱膏、導熱膠等。在一些高端PC的CPU中時而采用具有良好傳熱性能的相變材料等作為頂部連接材料。
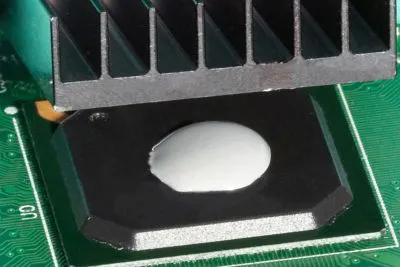
TIM2型材料用于封裝外部,位于散熱器和封裝之間。相較于TIM1,TIM2已遠離芯片,工作環境溫和,導熱性能要求相對較低,且無需電絕緣性。但它仍需有效傳導熱量,確保散熱。TIM2材料通常為碳基復合材料,且多為可分離設計,便于熱沉在系統級組裝過程中拆裝。
02 金屬和陶瓷基導熱材料
金屬導熱材料(如銅、鋁等)因其優異的導熱性,常用于極端環境下的芯片散熱。金屬的高導熱系數(如銅的導熱系數約為400 W/(m·K))使其能夠快速將熱量從發熱源傳遞出去,適合高熱通量應用場景。同時,金屬材料具備較高的機械強度和抗熱沖擊能力,廣泛應用于需要在惡劣環境下持續高效散熱的AI芯片中。
陶瓷導熱材料(如氮化鋁、氮化硅)不僅具有良好的導熱性,還具備電絕緣性,是許多AI芯片封裝和高功率應用中的理想選擇。陶瓷材料的導熱性介于金屬和傳統聚合物材料之間,且其熱穩定性使其能夠在高溫或腐蝕環境下使用。例如,氮化鋁的導熱系數高達170-180 W/(m·K),廣泛用于極端環境下的AI芯片封裝中。
散熱技術
散熱技術包括風扇、液冷、熱管、VC均熱板等,這些技術如何適用于AI芯片散熱,但面臨的局限性。
01 風扇
風扇散熱是將冷空氣吹過散熱器或直接吹向芯片表面,進而將芯片產生的熱量轉移到空氣中。
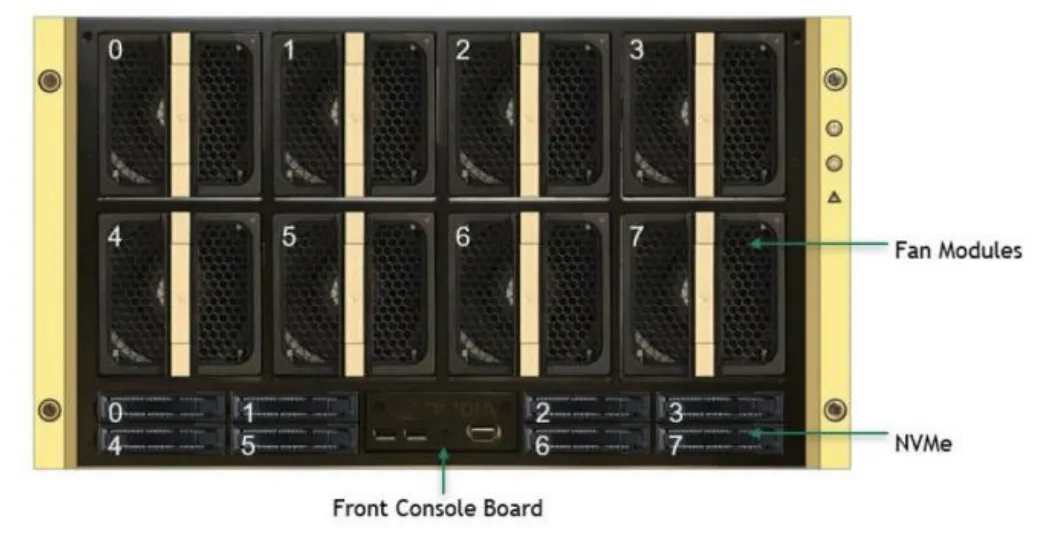
服務器風扇
優點:風扇散熱系統設計簡單,成本較低,安裝方便,且應用廣泛。風扇作為風冷散熱器的兩大重要部件之一,其性能對服務器散熱效果和使用壽命具一定決定性作用,也可以與熱管/3DVC/冷管等組合使用。
局限性:風冷的散熱效率受限于空氣的熱導率較低,在高負荷和密集運算的AI芯片中效果有限。
02 液冷
液冷技術通過將液體(如水或冷卻液)作為傳熱介質,利用其高熱容量和高導熱性,將AI芯片產生的熱量迅速帶走。液冷系統通常由冷卻液管路、冷板或散熱片、泵和散熱器組成,冷卻液吸收熱量后被送到散熱器,再通過空氣或水冷的方式散熱。
優點:液冷相較于風冷具有更高的散熱效率,因此常用于數據中心和高性能計算(HPC)中,比風冷更適合支持高功率AI芯片持續工作。
局限性:液冷系統復雜且成本較高,安裝和維護要求較高。此外,若系統出現泄漏,可能導致設備損壞。此外,液冷系統的物理空間占用較大。
03 熱管
熱管技術通過相變原理進行高效導熱。熱管內部包含導熱液體,液體在靠近熱源的部分吸收熱量蒸發成氣體,氣體沿熱管移動到冷端釋放熱量并凝結成液體,液體再通過毛細作用或重力回到熱源端循環。這種循環使得熱管能夠迅速傳導熱量。
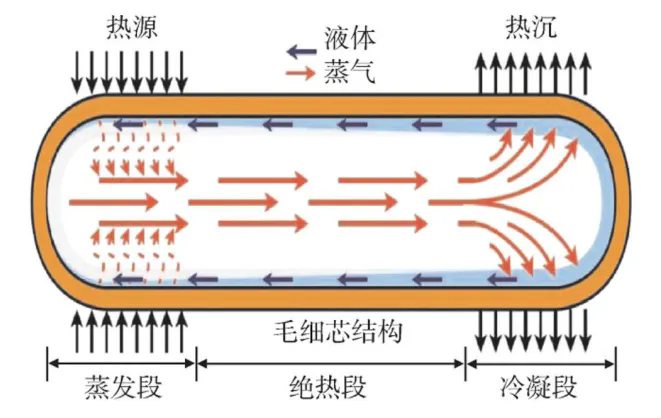
熱管的工作原理
優點:熱管具有極高的導熱效率,且體積較小,重量輕,適合應用于空間受限的設備中。
局限性:盡管熱管導熱效率高,但其散熱能力受到熱管數量和設計的限制,主要用于中等功耗或空間受限的場景,難以在超高功率芯片中單獨使用。
04 VC均熱板
在熱管的結構基礎上,二維均溫技術(VC均熱板)、三維的一體式均溫技術(3D VC均熱板)被逐漸被開發。均熱板與熱管的原理相似,都是讓冷卻液吸收熱源的能量,然后經過蒸發(吸熱)、冷凝(放熱)的相變過程,將熱量分散導向外部。
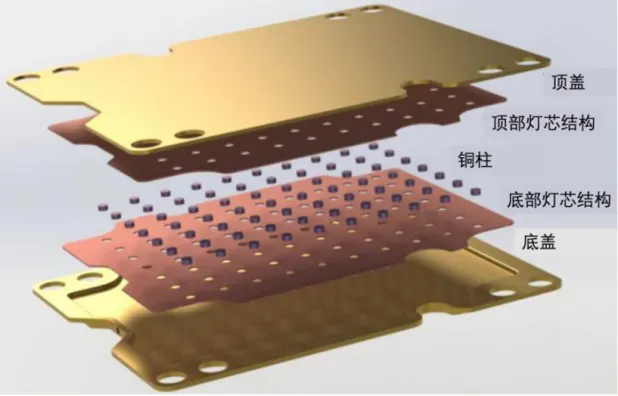
華為Mate60采用的VC均熱板
優點:均熱板可設計成任意形狀以適應不同的熱源布局,以二維甚至三維方式幫助器件散熱,接觸面積更大,散熱更均勻,相比熱管,傳熱效率提高了20% - 30%。同時其緊湊的設計也更利于安裝在小型化設備中。
局限性:VC均熱板的制造成本相對較高,尤其是在復雜三維結構的設計和制作上。此外,均熱板的散熱能力在極高功率密度下可能依然存在限制,難以單獨應對某些高熱負載場景,通常需要與其他散熱技術結合使用。
三、總結
導熱材料與散熱設計在AI芯片的性能表現中起到了至關重要的作用。高效的散熱系統不僅能夠維持芯片的穩定運行,還能防止過熱對其計算能力、能效和壽命的負面影響,尤其是在高負載的場景如邊緣計算和5G基站中,散熱設計的優劣直接影響整體系統的運行效率。
隨著AI產業的快速發展,AI芯片的功耗與熱管理需求也將持續增長。因此,未來在導熱材料和散熱技術領域的持續研發投入是必不可少的。通過不斷創新與優化,散熱解決方案才能夠滿足AI芯片在更大規模、更高性能場景中的應用需求,推動AI產業邁向新的高度。
上一篇:芯片,太熱了!
